E non è finita qua: Intel ha annunciato di aver sviluppato anche un modo completamente nuovi di "costruire" CPU, verticalmente. Santa Clara utilizza una nuova tecnologia di packaging 3D, denominata "Foveros", che per la prima volta offre i vantaggi dello stacking 3D per consentire integrazione logic-on-logic.
Foveros apre la strada a dispositivi e sistemi che combinano tecnologie di processo del silicio ad elevate prestazioni, alta densità e basso consumo. Foveros è destinata ad estendere lo stacking dei die oltre i tradizionali interposer passivi e memoria sovrapposta alla logica ad elevate prestazioni, come CPU, grafica e - per la prima volta - processori per l'intelligenza artificiale. Questa tecnologia offre un'enorme flessibilità man mano che i progettisti desiderano combinare blocchi IP di tecnologia con vari elementi di memoria e I/O nei nuovi formati dei dispositivi. Questo consentirà di suddividere i prodotti in "chiplet" più piccoli, in cui i circuiti di I/O, SRAM e alimentazione possono essere realizzati in un die di base su cui vengono impilati chiplet logici ad elevate prestazioni.
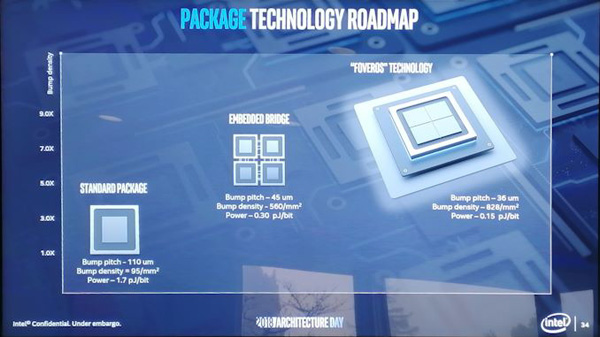
Intel prevede di lanciare una gamma di prodotti che utilizza Foveros a partire dalla seconda metà del 2019. Il primo prodotto Foveros combinerà un chiplet compute-stacked a 10 nm ad elevate prestazioni con un die di base 22FFL a basso consumo. Consentirà la combinazione di prestazioni avanzate ed efficienza energetica in una dimensione ridotta. Insomma, Foveros rappresenta il prossimo balzo in avanti dopo la rivoluzionaria tecnologia di packaging 2D Embedded Multi-die Interconnect Bridge (EMIB) di Intel, introdotta nel 2018.